QR код

Производи
Контактирајте не


Факс
+86-579-87223657

Е-пошта

Адреса
Wangda Road, улица Ziyang, Wuyi County, Jinhua City, провинција Жеџијанг, Кина
Силиконските карбидни подлоги имаат многу дефекти и не можат директно да се обработуваат. На нив треба да се одгледува специфичен единечен кристал тенок филм преку епитаксичен процес за да се направат нафора на чипови. Овој тенок филм е епитаксичен слој. Речиси сите уреди со силиконски карбид се реализираат на епитаксијални материјали. Висококвалитетниот силиконски карбид хомогени епитаксијални материјали се основа за развој на силиконски карбидни уреди. Перформансите на епитаксијални материјали директно ја одредуваат реализацијата на перформансите на силиконските карбидни уреди.
Силиконските карбидни уреди со висока струја и висока сигурност издвоија построги барања за морфологијата на површината, густината на дефектот, допингот и униформноста на дебелината на епитаксичните материјали. Густина со големи димензии, со ниска дефект и висока униформностСиликонски карбид епитаксистана клуч за развојот на индустријата за силиконски карбид.
Подготовка на висококвалитетноСиликонски карбид епитаксиБара напредни процеси и опрема. Најшироко користениот метод на епитаксијален раст на силиконски карбид е хемиско таложење на пареа (CVD), кој има предности на прецизна контрола на дебелината на епитаксичната филм и концентрацијата на допинг, помалку дефекти, умерена стапка на раст и автоматска контрола на процесите. Тоа е сигурна технологија која е успешно комерцијализирана.
Епитаксијата на силиконски карбид CVD генерално користи опрема за топол wallид или топол wallид CVD, што обезбедува продолжување на епитаксијалниот слој 4H кристал SIC под повисоки услови на температура на раст (1500-1700 ℃). После долгогодишно развојот, топол wallид или топол wallид CVD може да се подели на хоризонтални реактори на хоризонтална структура и реактори на вертикална вертикална структура според врската помеѓу насоката на влезниот проток на гас и површината на подлогата.
Квалитетот на силиконскиот карбид епитаксијална печка главно има три индикатори. Првиот е перформансите на епитаксијален раст, вклучително и униформност на дебелината, униформност на допинг, стапка на дефекти и стапка на раст; Втората е температурната изведба на самата опрема, вклучително и стапката на греење/ладење, максимална температура, температурна униформност; и конечно, перформансите на трошоците на самата опрема, вклучително и единечна цена и капацитет на производство.
Хоризонтално CVD на топол wallид, топол wallиден планетарна CVD и квази-жешка wallидна вертикална CVD се главни решенија за технологија на епитаксијална опрема кои се комерцијално применети во оваа фаза. Трите техничка опрема исто така имаат свои карактеристики и можат да бидат избрани според потребите. Дијаграмот на структурата е прикажан на сликата подолу:

Хоризонталниот CVD систем на топол wallид е генерално систем за раст со голема големина на големи димензии, управуван од флотација и ротација на воздухот. Лесно е да се постигнат добри индикатори за влечење. Претставничкиот модел е PE1O6 на компанијата LPE во Италија. Оваа машина може да реализира автоматско вчитување и истовар на нафора на 900. Главните карактеристики се висока стапка на раст, краток епитаксијален циклус, добра конзистентност во рамките на нафтата и помеѓу печките, итн. Има најголем удел на пазарот во Кина.

According to LPE official reports, combined with the usage of major users, the 100-150mm (4-6 inches) 4H-SiC epitaxial wafer products with a thickness of less than 30μm produced by the Pe1O6 epitaxial furnace can stably achieve the following indicators: intra-wafer epitaxial thickness non-uniformity ≤2%, intra-wafer doping concentration non-uniformity ≤5%, густина на површински дефект ≤1cm-2, површинска површина без дефект (единечна ќелија 2мм × 2мм) ≥90%.
Домашните компании како што се JSG, CETC 48, NAURA и NASO развиле монолитна силиконска карбид епитаксична опрема со слични функции и имаат постигнато пратки од големи размери. На пример, во февруари 2023 година, ЈСГ објави 6-инчен двојно-вафер епитаксична опрема SIC. Опремата ги користи горните и долните слоеви на горните и долните слоеви на графитските делови на комората за реакција за да одгледуваат две епитаксични нафори во една печка, а горните и долните процесни гасови можат да бидат одделно регулирани, со температурна разлика од ≤5 ° C, што ефикасно го сочинува за непостоењето на недоволно производство на капацитет на монолит хоризонтален ев.Sic обложување на делови од полувремеНа корисниците им обезбедуваме 6 инчи и 8 инчни полувремени делови на корисниците.

Системот на планетарниот CVD на топол wallид, со планетарно уредување на основата, се карактеризира со раст на повеќе нафора во една печка и висока излезна ефикасност. Претставничките модели се AIXG5WWC (8x150mm) и G10-SIC (9 × 150mm или 6 × 200 mm) епитаксична опрема на Aixtron на Германија.
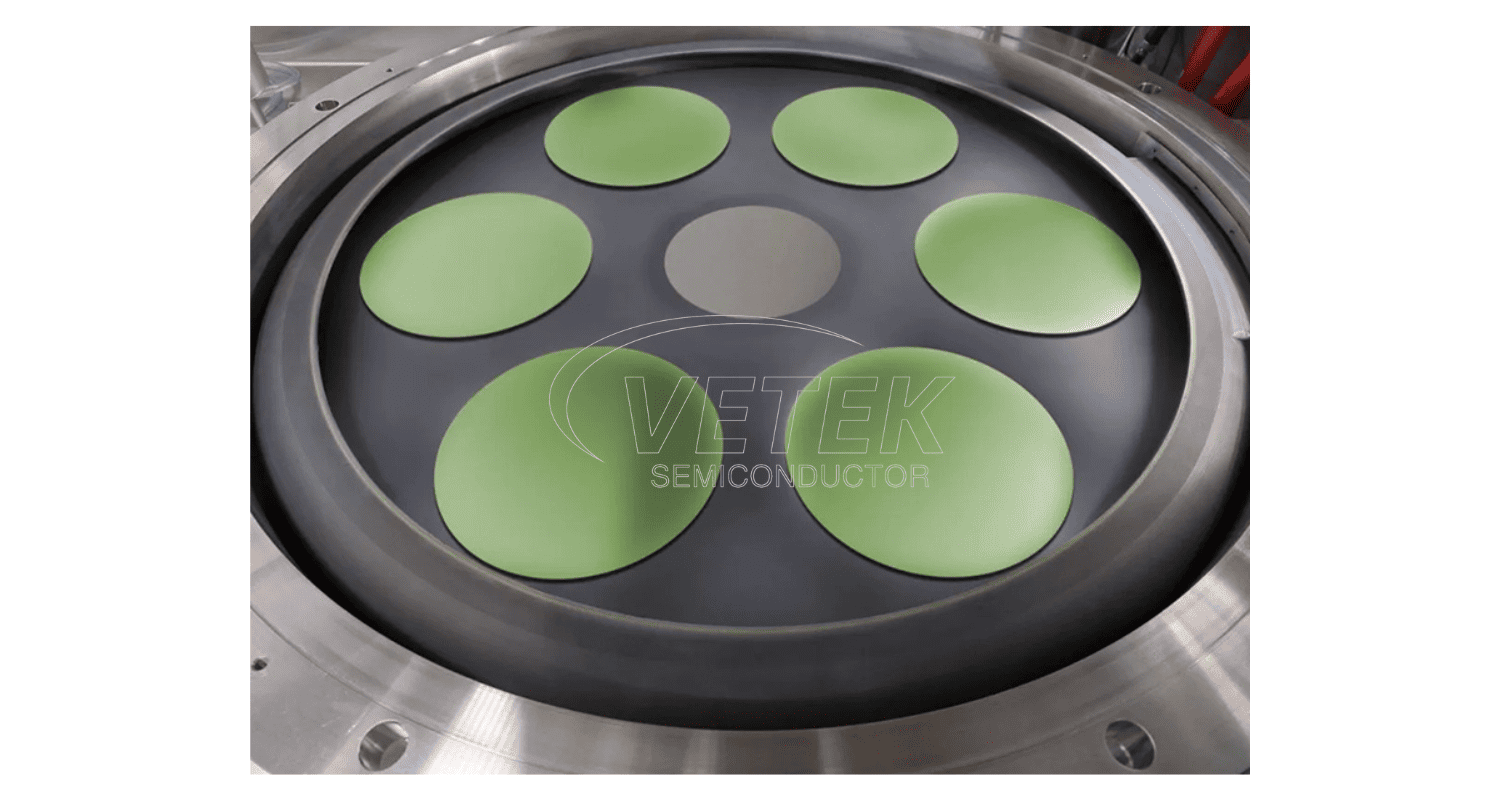
Според официјалниот извештај на Aixtron, 6-инчните 4H-SIC епитаксијални нафори со дебелина од 10 μm произведени од епитаксијалната печка G10 можат стабилно да ги постигнат следниве индикатори: меѓу-вофер епитаксијална дебелина отстапување од 2,5%, интра-во-во-во-во-во-во-во-во-во-во-во-во текот концентрација на допинг не-униформност <2%.
До сега, овој вид на модел ретко се користи од домашните корисници, а податоците за производство на серии се недоволни, што до одреден степен ја ограничува неговата инженерска апликација. Покрај тоа, како резултат на високите технички бариери на мулти-појавите епитаксијални печки во однос на контролата на полето на температурата и полето на проток, развојот на слична домашна опрема е сè уште во фаза на истражување и развој, и нема алтернативен модел. Во меѓувреме, можеме да обезбедиме планетарни подложни на Aixtron како 6 инчи и 8 инчи со обложување на TAC или SIC обложување.
Вертикалниот CVD систем на квази-wallид главно ротира со голема брзина преку надворешна механичка помош. Неговата карактеристика е дека дебелината на вискозниот слој е ефикасно намалена со помал притисок на комората на реакцијата, а со тоа се зголемува и стапката на раст на епитаксија. Во исто време, неговата комора за реакција нема горен wallид на кој може да се депонираат честички на SIC и не е лесно да се произведат предмети што паѓаат. Има својствена предност во контролата на дефекти. Претставничките модели се епитаксијални печки со еднократна употреба epirevos6 и epirevos8 на јапонскиот Nuflare.
Според Nuflare, стапката на раст на уредот EPIREVOS6 може да достигне повеќе од 50 μm/h, а густината на дефектот на површината на епитаксијалниот нафора може да се контролира под 0,1 см -²; Во однос на контролата на униформноста, инженерот Nuflare Yoshiaki Daigo ги пријавил резултатите од интра-вофер униформност на 10μm дебели 6-инчни епитаксични нафори одгледувани со употреба на Epirevos6Горниот цилиндер на графит.
Во моментов, производителите на домашна опрема, како што се Core Thard Generation и JSG, дизајнираа и лансираа епитаксична опрема со слични функции, но тие не се користени во голем обем.
Во принцип, трите типа на опрема имаат свои карактеристики и зафаќаат одреден удел на пазарот во различни потреби за апликација:
Хоризонталната CVD структура на топол wallид има ултра брза стапка на раст, квалитет и униформност, едноставна опрема и одржување на опрема и зрели апликации за производство во големи размери. Сепак, поради типот со еден вложен вид и честото одржување, ефикасноста на производството е мала; Топлиот wallиден планетарна CVD генерално усвојува структура на фиоката 6 (парче) × 100 mm (4 инчи) или 8 (парче) × 150 mm (6 инчи), што во голема мерка ја подобрува ефикасноста на производството на опремата во однос на производствениот капацитет, но тешко е да се контролира конзистентноста на повеќе парчиња, а производствениот принос е сè уште најголем проблем; Вертикалното CVD-Quasi-Hot wallид има комплексна структура, а квалитетна контрола на дефектот на производството на епитаксиална нафта е одлична, за која е потребно искуство со исклучително богата опрема за одржување и употреба на опрема.
Брза стапка на раст
Едноставно структура на опрема и
удобно одржување
Голем производствен капацитет
Висока ефикасност на производството
Добра контрола на дефектот на производот
Долга комора на реакција
циклус на одржување
Комплексна структура
тешко е да се контролира
Конзистентност на производот
Сложена структура на опрема,
Тешко одржување
Претставник
опрема
производители
Хоризонтално CVD на топол wallид
Топол wallиден планет CWD
Quasi-Hotиден wallиден вертикален CTD
Предности
Недостатоци
Краток циклус на одржување
Италија ЛПЕ, Јапонија Тел
Германија Акстрон
Јапонија Нуфларе
Со континуиран развој на индустријата, овие три типа на опрема ќе бидат итеративно оптимизирани и надградени во однос на структурата, а конфигурацијата на опремата ќе стане сè посовршена, играјќи важна улога во совпаѓање на спецификациите на епитаксијалните нафора со различни дебелини и барања за дефект.



+86-579-87223657


Wangda Road, улица Ziyang, Wuyi County, Jinhua City, провинција Жеџијанг, Кина
Авторски права © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Сите права се задржани.
Links | Sitemap | RSS | XML | Политика за приватност |
