QR код

Производи
Контактирајте не


Факс
+86-579-87223657

Е-пошта

Адреса
Wangda Road, улица Ziyang, Wuyi County, Jinhua City, провинција Жеџијанг, Кина
Подготовката на висококвалитетна силиконска карбид епитаксија зависи од напредната технологија и додатоци за опрема и опрема. Во моментов, најчесто користениот метод на раст на епитаксијата на силиконски карбид е хемиска таложење на пареа (CVD). Има предности на прецизна контрола на дебелината на епитаксијалниот филм и концентрацијата на допинг, помалку дефекти, умерена стапка на раст, автоматска контрола на процесите, итн., И е сигурна технологија која успешно се применува комерцијално.
Епитаксијата на силиконски карбид CVD генерално усвојува опрема за топол wallид или топол wallид CVD, што обезбедува продолжување на епитаксискиот слој 4H кристален SIC под услови на висока температура на раст (1500 ~ 1700 ℃), топол wallид или топол wallиден CVD по години на развој, според врската помеѓу насоката на протокот на воздухот и подлогата на подлогата, реакцијата на реакцијата, реакцијата на реакторот.
Постојат три главни индикатори за квалитетот на SIC епитаксијалната печка, првата е епитаксијална перформанси на раст, вклучително и униформност на дебелината, униформност на допинг, стапка на дефекти и стапка на раст; Втората е температурната изведба на самата опрема, вклучително и стапката на греење/ладење, максимална температура, температурна униформност; Конечно, перформансите на трошоците на самата опрема, вклучувајќи ја и цената и капацитетот на една единица.
Хоризонтално CVD на топол wallид (типичен модел PE1O6 на компанијата LPE), топол wallиден планетарна CVD (типичен модел Aixtron G5WWC/G10) и Quasi-Hot Wall Wall CVD (претставен со Epirevos6 на компанијата Nuflare) се техничките решенија за епитаксијална опрема што се реализирани во комерцијалните апликации во оваа фаза. Трите технички уреди исто така имаат свои карактеристики и можат да бидат избрани според побарувачката. Нивната структура е прикажана на следниов начин:
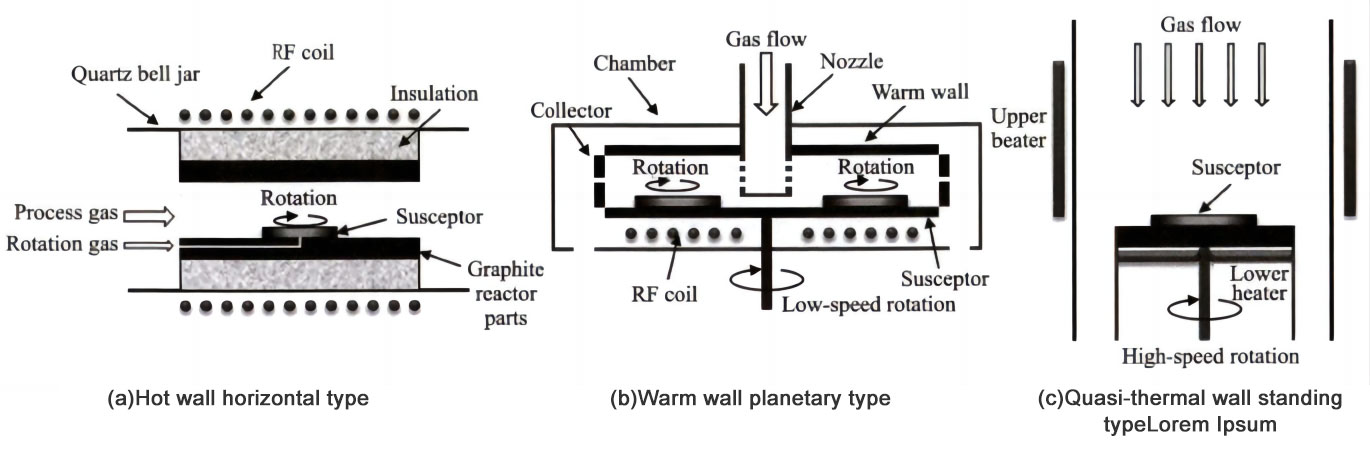

Низводно изолација
Главна изолација горниот
Горниот полувреме
Возводно изолација
Парче за транзиција 2
Парче за транзиција 1
Надворешна млазница за воздух
Затегната нуркачка
Надворешна млазница за гас Аргон
Аргон гас млазницата
Плоча за поддршка на нафта
Центрирање на игла
Централна гарда
Покрив за заштита од лево
Покрив за заштита од десната страна
Покрив за лево за заштита од возводно
Покрив за заштита од низводно десно
Страничен wallид
Графитски прстен
Заштитно чувство
Поддршка почувствува
Контакт блок
Цилиндер за излез на гас

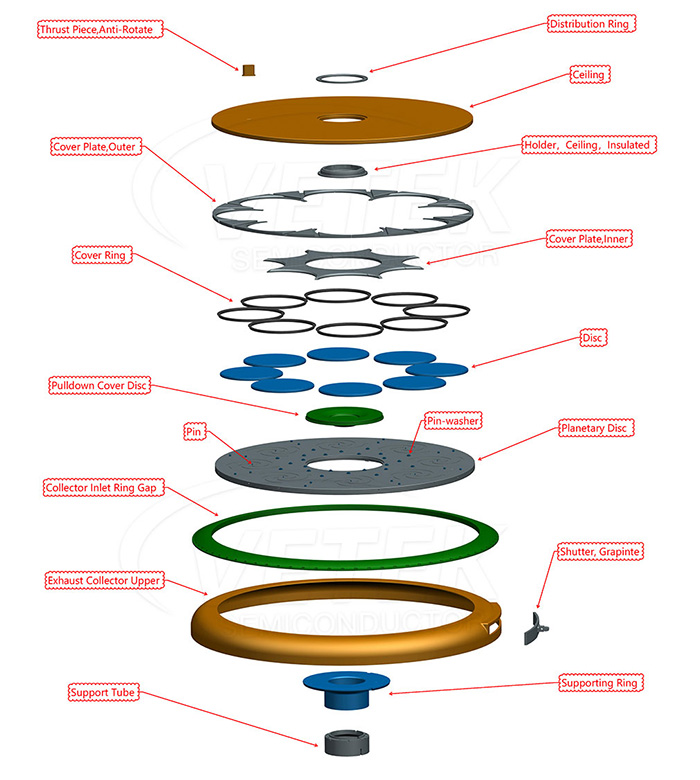

SIC обложување на планетарниот диск и TAC обложен планетарна диск
Nuflare (Јапонија): Оваа компанија нуди вертикални печки со двојна комора кои придонесуваат за зголемен принос на производството. Опремата има голема брзина ротација до 1000 револуции во минута, што е многу корисно за епитаксична униформност. Покрај тоа, неговата насока на проток на воздух се разликува од друга опрема, што е вертикално надолу, со што се минимизира генерирањето на честички и ја намалува веројатноста за капки честички што паѓаат на нафорите. Ние нудиме основни компоненти обложени со графитни компоненти за оваа опрема.

Како снабдувач на компоненти на епитаксична опрема SIC, Vetek Semiconductor е посветен на клиентите со висококвалитетни компоненти на облогата за поддршка на успешно спроведување на SIC Epitaxy.
Veteksemicon silicon carbide epitaxy is your advanced procurement option for producing high-performance 4H-SiC and 6H-SiC epitaxial layers used in wide bandgap semiconductor devices. SiC epitaxy enables the formation of defect-controlled, dopant-engineered epitaxial layers critical for high-power, high-frequency, and high-temperature electronic devices.
Our offering includes specialized components such as SiC epitaxial susceptors, SiC-coated wafer holders, and epitaxy process rings, tailored for use in horizontal and vertical MOCVD and CVD reactors, including platforms by Veeco, Aixtron, and LPE. Veteksemicon’s parts are coated with high-purity CVD SiC, ensuring chemical compatibility, temperature uniformity, and minimal contamination during epitaxial layer growth.
Silicon carbide epitaxy is essential for fabricating power MOSFETs, IGBTs, and RF components, particularly in automotive, energy, and aerospace applications. The epitaxial process requires extremely precise control over doping concentration, layer thickness, and crystallographic orientation, which is why substrate compatibility and thermal stability of reactor parts are critical.
Relevant terms in this category include 4H-SiC epitaxial wafer, low-defect-density epitaxy, SiC epi-ready substrates, and wide bandgap semiconductors. Veteksemicon supports both research-scale and volume production needs with stable, repeatable, and thermally robust component solutions.
To learn more about our silicon carbide epitaxy support materials, visit the Veteksemicon product detail page or contact us for detailed specifications and engineering support.