QR код

Производи
Контактирајте не


Факс
+86-579-87223657

Е-пошта

Адреса
Wangda Road, улица Ziyang, Wuyi County, Jinhua City, провинција Жеџијанг, Кина
Во полупроводниците и приказните на панелот FPD, подготовката на тенки филмови е важен процес. Постојат многу начини да се подготват тенки филмови (TF, тенок филм), следниве два методи се вообичаени:
● CVD (таложење на хемиска пареа)
● ПВД (физичко таложење на пареа)
Меѓу нив, тампон слој/активен слој/изолациски слој се депонирани во комората на машината користејќи PECVD.
● Користете специјални гасови: SiH4/NH3/N2O за таложење на филмовите SiN и Si/SiO2.
● Некои CVD машини треба да користат H2 за хидрогенизација за да ја зголемат мобилноста на носачот.
● NF3 е гас за чистење. За споредба: F2 е многу токсичен, а ефектот на стаклена градина на SF6 е повисок од оној на NF3.
Во процесот на полупроводнички уреди има повеќе видови на тенки фолии, покрај обичните SiO2/Si/SiN има и W, Ti/TiN, HfO2, SiC итн.
Ова е исто така причината зошто има многу видови на прекурсори за напредни материјали што се користат во индустријата за полупроводници, со цел да се направат разни видови на тенки филмови.
1. Видови на CVD и некои претходни гасови
2. Основен механизам на CVD и квалитетот на филмот
CVD е многу општ концепт и може да се подели на многу видови. Вообичаени се:
● Pecvd: CVD зајакната со плазма
● LPCVD: CVD со низок притисок
● ALD: таложење на атомски слој
● MOCVD: Метал-органско ЦВД
За време на CVD процесот, хемиските врски на претходникот треба да се прекинат пред хемиските реакции.
Енергијата за кршење на хемиски врски доаѓа од топлина, така што температурата на комората ќе биде релативно висока, што не е пријателска за некои процеси, како што е стаклото на подлогата на панелот или PI материјалот на флексибилниот екран. Затоа, со внесување друга енергија (формирање плазма, итн.) За да се намали температурата на процесот за да се исполнат некои процеси што бараат температура, ќе се намали и термичкиот буџет.
Затоа, таложењето на PECVD на a-Si:H/SiN/poly-Si е широко користено во индустријата за прикажување на FPD. Вообичаени прекурсори и филмови за CVD:
Поликристален силициум/еднокристален силициум SiO2 SiN/SiON W/Ti WSi2 HfO2/SiC
Чекори на основниот механизам на CVD:
1. Гасот прекурсор на реакција влегува во комората
2. Средни производи произведени со реакција на гас
3. Средните производи на гасот се дифузираат на површината на подлогата
4. Адсорбиран на површината на подлогата и дифузен
5. Хемиска реакција се јавува на површината на подлогата, формирање на нуклеација/остров/формирање на филм
6. нуспроизводи се десортирани, вакуум се испумпуваат и испуштени по влегувањето во чистачот на лекување
Како што споменавме порано, целиот процес вклучува повеќе чекори како што е дифузија/адсорпција/реакција. Целокупната стапка на формирање на филмот е под влијание на многу фактори, како што се температура/притисок/вид на реакција гас/вид на подлога. Дифузијата има модел на дифузија за предвидување, адсорпцијата има теорија на адсорпција, а хемиската реакција има теорија на кинетика на реакција.
Во целиот процес, најбавниот чекор ја одредува целата стапка на реакција. Ова е многу слично на методот на критична патека за управување со проекти. Најдолгиот проток на активност го одредува најкраткото времетраење на проектот. Времетраењето може да се скрати со распределување на ресурси за да се намали времето на оваа патека. Слично на тоа, CVD може да го најде клучното тесно грло што ја ограничува стапката на формирање филм со разбирање на целиот процес и да ги прилагоди поставките на параметарот за да ја постигне идеалната стапка на формирање филм.
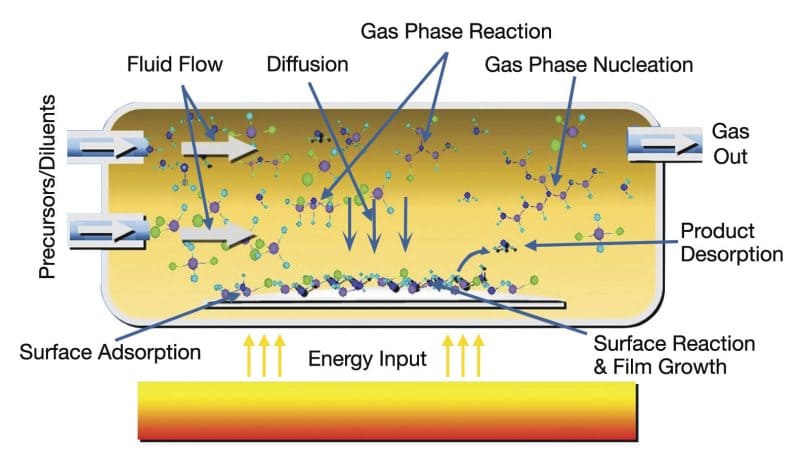
Некои филмови се рамни, некои се полнења со дупки, а некои се полнење на жлебови, со многу различни функции. Комерцијалните CVD машини мора да ги исполнуваат основните барања:
● Капацитет за обработка на машината, стапка на таложење
● Конзистентност
● Реакциите на гасната фаза не можат да произведат честички. Многу е важно да не се создаваат честички во гасната фаза.
Некои други барања за евалуација се како што следува:
● Добар чекор покриеност
● Способност да се пополнат празнините со висок сооднос (конформалност)
● Добра униформност на дебелината
● Висока чистота и густина
● Висок степен на структурна совршенство со мал стрес на филмот
● Добри електрични својства
● Одлична адхезија на материјалот на подлогата



+86-579-87223657


Wangda Road, улица Ziyang, Wuyi County, Jinhua City, провинција Жеџијанг, Кина
Авторски права © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Сите права се задржани.
Links | Sitemap | RSS | XML | Политика за приватност |
